Bewährte Binärmasken
Lösungen, wo Sie sie brauchen
Unsere weltweiten Produktionsstätten bieten lokale Lösungen für Retikel (hauptsächlich 2X bis 5X), Ultratech 1X-Retikel und Standard 1X-Fotomasken in Größen von 4 bis 14 Zoll für die Herstellung von integrierten Schaltkreisen an. Wir liefern auch 1X-Master und Kopien mit optionalen Antihaftbeschichtungen. Die Fertigungsausrüstungen sind für schnelle Zykluszeiten und niedrige Kosten optimiert, ohne Qualitätskompromisse.
Verlängern Sie die Nutzung Ihrer Ausrüstungen
Unsere ausgereiften Lösungen für binäre Masken basieren auf bewährten Technologien und werden in Serie hergestellt, um Ihre Anforderungen an die Waferproduktion für eine Vielzahl von Anwendungen zu erfüllen. Auf diese Weise können Sie die Rendite maximieren, indem Sie die Nutzung Ihrer bewährten Lithografiesysteme verlängern.
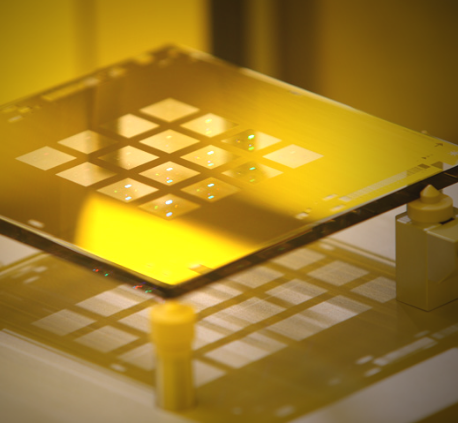
Fortschrittliche binäre OPC-Masken
Weiterentwicklung des Technologieniveaus
Bei Photronics haben wir mit den Fortschritten der Technologie Schritt gehalten, bei der die Grenzen der Lithografie durch extreme low k1-processing und durch high mask error enhancement factor (MEEF) immer weiter verschoben werden. Unsere hochentwickelten binären Retikel unterstützen problemlos Technologieniveaus von 14 nm bis 28 nm, wobei Entwicklung und Innovation bei 7 nm und darunter, einschließlich EUV, klar im Blickpunkt stehen.
Schlüsselfaktoren
- Elektronenstrahl-Lithografietools und chemisch verstärkter Resist (CAR) lösen sehr kleine Haupt- und OPC-Strukturen auf der Maske auf.
- Fortschrittliche Laserlithografie-Tools bieten eine kostengünstige Lösung, wenn die maximale Auflösung weniger kritisch ist.
- Das Trockenätzen sichert die Strukturgenauigkeit durch Minimierung der CD-Verluste, bei der Übertragung der Resistvorlage auf die Chromabschicht.
Gemeinsame Spezifikationen
| Binary Photomasks | ||||
|---|---|---|---|---|
| Standard binary photomasks are typically used for 1X, 2X 2.5X, 4X and 5X applications |
||||
| Mask sizes range from 4"x4" to 9"x9" | ||||
| Common Specifications for Binary masks, of course we will work with our customers if tighter requirements are needed |
||||
| CD Size | CD Tolerance | CD Uniformity | Registration | Defect Size |
| 1.0-2.0μ | ±1.5μ | .15μ | ±.15μ | .50μ |
| >2.0μ | ±.20μ | .20μ | ±.15μ | 1.0μ |
| Advanced Binary Photomasks | ||||
|---|---|---|---|---|
| Advanced Binary photomasks are typically used for 1X, 4X and 5X applications | ||||
| Mask size is typically 6"x6" | ||||
| Common Specifications for Advanced Binary masks, of course we will work with our customers if tighter requirements are needed | ||||
| CD Size | CD Tolerance | CD Uniformity | Registration | Defect Size |
| .50μ-1.0μ | ±.035μ | .035μ | ±.03μ | .20μ |
| >1.0μ | ±.05μ | .05μ | ±.05μ | .03μ |
| Large Area Photomasks | ||||
|---|---|---|---|---|
| Mask size raging from 9"x9" up to 24"x30" | ||||
| Common Specifications for LAM, of course we will work with our customers if tighter requirements are needed |
||||
| CD Size | CD Tolerance | CD Uniformity | Registration | Defect Size |
| >2.0μ | ±.50μ | .50μ | ±1.0μ | 1.0μ |
Phasenmasken
Bessere Auflösung und DOF
Bei Wellenlängen von 248 nm und 193 nm verwenden unsere Halbtonphasenmasken (EAPSM) einen wellenlängenabhängigen MoSiON-Absorber mit 6 % Transmission, um eine Phasenverschiebung von 180 Grad zu erzielen. Dies verbessert die Auflösung und Schärfentiefe des Lithografie-Tools.
EUV Masken
Nach Jahren des Wartens ist die EUV-Technologie endlich in Produktion. Damit hat man die Fähigkeit, Technologieniveaus auf Struktur-Größen von 5 nm und weniger zu bringen. Unser Forschungs- und Entwicklungsteam hat eine wichtige Rolle bei dieser Lithografieentwicklung der nächsten Generation gespielt, einschließlich einer gemeinsamen Forschungs- und Entwicklungsvereinbarung mit IBM Research zur Entwicklung von EUV-Maskenprozessen für führende Logikanwendungen für 7-nm- und 5-nm-Technologieniveaus und darüber hinaus. Infolgedessen ist unser Technologieportfolio in der Lage, schnell zu reagieren, wenn EUV-Fotomasken zum Mainstream werden.
Hauptgesichtspunkte
- Strukturierung der oberste Chromschicht mit modernsten E-Beam- oder Laserschreibtools.
- Erstellen einr Vorlage für MoSiON unter der oberen Chromschicht mithilfe eines Trockenätzprozesses mit induktiv gekoppeltem Plasma (ICP).
- Strukturierung des aktiven Phasenverschiebungsbereichs, indem die Maske mit Resist neu beschichtet und mit dem Laserschreiber die zweite Ebene belichtet wird. Die Passmarken, der Barcode und die Titel der Maske bleiben in kontrastreichem Chrom.
- Reparieren der kritische Defekte (CDs) mit precision-beam oder atomic-force Ausrüstungen.
- Nachweis der CDs durch aerial image metrology (AIMS).
- Minimieren des Risikos von HAZE Effekten durch proprietäre Reinigung und Behandlung.
Der Umwelt verpflichtet
Wir bei Photronics fühlen uns dem Schutz unserer Umwelt verpflichtet. Aus diesem Grund haben wir zusammen mit unseren Kunden und Substratlieferanten ein Programm zur Rückgewinnung von Quarzsubstraten entwickelt. Mit Zustimmung des Kunden recyceln und wiederverwenden wir Substrate für weniger kritische Anwendungen. Durch dieses Programm haben wir erfolgreich Abfall reduziert und gleichzeitig das geistige Eigentum unserer Kunden geschützt.
Neben dem Programm zur Substratrückgewinnung werden auch Verpackungen wiederverwendet.